【導(dǎo)讀】Test Coupon,是用來以 TDR (Time Domain Reflectometer 時(shí)域反射計(jì)) 來測(cè)量所生產(chǎn)的 PCB 的特性阻抗是否滿足設(shè)計(jì)的要求,一般要控制的阻抗有單端線和差分對(duì)兩種情況,所以 test coupon 上的走線線寬和線距(有差分對(duì)時(shí))要與所要控制的線一樣,最重要的是測(cè)量時(shí)接地點(diǎn)的位置。

Test Coupon: 俗稱阻抗條

Test Coupon,是用來以 TDR (Time Domain Reflectometer 時(shí)域反射計(jì)) 來測(cè)量所生產(chǎn)的 PCB 的特性阻抗是否滿足設(shè)計(jì)的要求,一般要控制的阻抗有單端線和差分對(duì)兩種情況,所以 test coupon 上的走線線寬和線距(有差分對(duì)時(shí))要與所要控制的線一樣,最重要的是測(cè)量時(shí)接地點(diǎn)的位置。為了減少接地引線(ground lead) 的電感值,TDR 探棒(probe)接地的地方通常非常接近量信號(hào)的地方(probe tip),所以 test coupon 上量測(cè)信號(hào)的點(diǎn)跟接地點(diǎn)的距離和方式要符合所用的探棒的規(guī)格。
▍ 金手指

金手指(Gold Finger,或稱Edge Connector)設(shè)計(jì)的目的,是用來與連接器(Connector)彈片之間的連接進(jìn)行壓迫接觸而導(dǎo)電互連.之所以選擇金是因?yàn)樗鼉?yōu)越的導(dǎo)電性及抗氧化性.你電腦里頭的內(nèi)存條或者顯卡版本那一排金燦燦的東西就是金手指了。
那問題來了,金手指上的金是黃金嗎?老wu覺得應(yīng)該是金的,但不是純金。為啥?應(yīng)為純金的硬度不夠,我們看古裝劇里,那些為了驗(yàn)證金元寶是不是真金的,都會(huì)用大門牙去咬一下看看有沒有牙印,老wu不知道這是不是神編劇在鬼扯,但金手指要應(yīng)付經(jīng)常性的插拔動(dòng)作,所以相對(duì)于純金這種“軟金”,金手指一般是電鍍“硬金”,這里的硬金是電鍍合金(也就是Au及其他的金屬的合金),所以硬度會(huì)比較硬。
▍ 硬金,軟金
硬金:Hard Gold;軟金 soft Gold
電鍍軟金是以電鍍的方式析出鎳金在電路板上,它的厚度控制較具彈性。一般則用于COB(Chip On Board)上面打鋁線用,或是手機(jī)按鍵的接觸面,而用金手指或其它適配卡、內(nèi)存所用的電鍍金多數(shù)為硬金,因?yàn)楸仨毮湍ァ?/div>
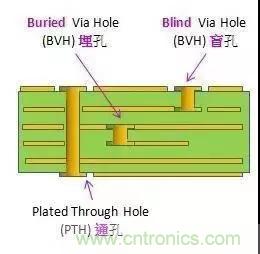




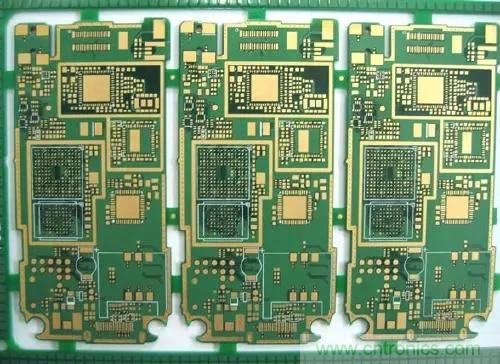



想了解硬金及軟金的由來,最好先稍微了解一下電鍍金的流程。姑且不談前面的酸洗過程,電鍍的目基本上就是要將「金」電鍍于電路板的銅皮上,但是「金」與「銅」直接接觸的話會(huì)有電子遷移擴(kuò)散的物理反應(yīng)(電位差的關(guān)系),所以必須先電鍍一層「鎳」當(dāng)作阻隔層,然后再把金電鍍到鎳的上面,所以我們一般所謂的電鍍金,其實(shí)際名稱應(yīng)該叫做「電鍍鎳金」。
而硬金及軟金的區(qū)別,則是最后鍍上去的這層金的成份,鍍金的時(shí)候可以選擇電鍍純金或是合金,因?yàn)榧兘鸬挠捕缺容^軟,所以也就稱之為「軟金」。因?yàn)椤附稹箍梢院汀镐X」形成良好的合金,所以COB在打鋁線的時(shí)候就會(huì)特別要求這層純金的厚度。
另外,如果選擇電鍍金鎳合金或是金鈷合金,因?yàn)楹辖饡?huì)比純金來得硬,所以也就稱之為「硬金」。
▍ 通孔:Plating Through Hole 簡(jiǎn)稱 PTH
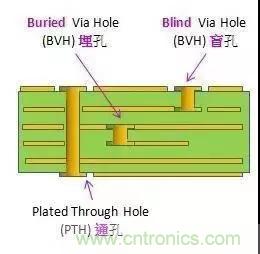
電路板不同層中導(dǎo)電圖形之間的銅箔線路就是用這種孔導(dǎo)通或連接起來的,但卻不能插裝組件引腿或者其他增強(qiáng)材料的鍍銅孔。印制電路板(PCB)是由許多的銅箔層堆疊累積形成的。銅箔層彼此之間不能互通是因?yàn)槊繉鱼~箔之間都鋪上了一層絕緣層,所以他們之間需要靠導(dǎo)通孔(via)來進(jìn)行訊號(hào)鏈接,因此就有了中文導(dǎo)通孔的稱號(hào)。
通孔也是最簡(jiǎn)單的一種孔,因?yàn)橹谱鞯臅r(shí)候只要使用鉆頭或激光直接把電路板做全鉆孔就可以了,費(fèi)用也就相對(duì)較便宜??墒窍鄬?duì)的,有些電路層并不需要連接這些通孔,但過孔卻是全板貫通,這樣就會(huì)形成浪費(fèi),特別是對(duì)于高密度HDI板的設(shè)計(jì),電路板寸土寸金。所以通孔雖然便宜,但有時(shí)候會(huì)多用掉一些PCB的空間。
▍ 盲孔:Blind Via Hole(BVH)
將PCB的最外層電路與鄰近內(nèi)層以電鍍孔連接,因?yàn)榭床坏綄?duì)面,所以稱為「盲孔」。為了增加PCB電路層的空間利用,應(yīng)運(yùn)而生「盲孔」工藝。
盲孔位于電路板的頂層和底層表面,具有一定的深度,用于表層線路同下面內(nèi)層線路的連接,孔的深度一般有規(guī)定的比率(孔徑)。這種制作方式需要特別注意,鉆孔深度一定要恰到好處,不注意的話會(huì)造成孔內(nèi)電鍍困難。因此也很少有工廠會(huì)采用這種制作方式。其實(shí)讓事先需要連通的電路層在個(gè)別電路層的時(shí)候先鉆好孔,最后再黏合起來也是可以的,但需要較為精密的定位和對(duì)位裝置。
▍ 埋孔:Buried Via Hole (BVH)
埋孔,就是印制電路板(PCB)內(nèi)部任意電路層間的連接,但沒有與外層導(dǎo)通,即沒有延伸到電路板表面的導(dǎo)通孔的意思。
這個(gè)制作過程不能通過電路板黏合后再進(jìn)行鉆孔的方式達(dá)成,必須要在個(gè)別電路層的時(shí)候就進(jìn)行鉆孔操作,先局部黏合內(nèi)層之后進(jìn)行電鍍處理,最后全部黏合。由于操作過程比原來的導(dǎo)通孔和盲孔更費(fèi)勁,所以價(jià)格也是最貴的。這個(gè)制作過程通常只用于高密度的電路板,增加其他電路層的空間利用率。
我們?cè)诋嫼肞CB后,將其發(fā)送給PCB板廠打樣或者是批量生產(chǎn),我們?cè)诮o板廠下單時(shí),會(huì)附上一份PCB加工工藝說明文檔,其中有一項(xiàng)就是要注明選用哪種PCB表面處理工藝,而且不同的PCB表面處理工藝,其會(huì)對(duì)最終的PCB加工報(bào)價(jià)產(chǎn)生比較大的影響,不同的PCB表面處理工藝會(huì)有不同的收費(fèi),下邊咱們科普一些關(guān)于PCB表面處理工藝的術(shù)語。
▍ 為什么要對(duì)PCB表面進(jìn)行特殊的處理
因?yàn)殂~在空氣中很容易氧化,銅的氧化層對(duì)焊接有很大的影響,很容易形成假焊、虛焊,嚴(yán)重時(shí)會(huì)造成焊盤與元器件無法焊接,正因如此,PCB在生產(chǎn)制造時(shí),會(huì)有一道工序,在焊盤表面涂(鍍)覆上一層物質(zhì),保護(hù)焊盤不被氧化。
目前國(guó)內(nèi)板廠的PCB便面處理工藝有:噴錫(HASL,hot air solder leveling 熱風(fēng)整平)、沉錫、沉銀、OSP(防氧化)、化學(xué)沉金(ENIG)、電鍍金等等,當(dāng)然,特殊應(yīng)用場(chǎng)合還會(huì)有一些特殊的PCB表面處理工藝。
對(duì)比不同的PCB表面處理工藝,他們的成本不同,當(dāng)然所用的場(chǎng)合也不同,只選對(duì)的不選貴的,目前還沒有最完美的PCB表面處理工藝能夠適合所有應(yīng)用場(chǎng)景(這里講的是性價(jià)比,即以最低的價(jià)格就能滿足所有的PCB應(yīng)用場(chǎng)景),所以才會(huì)有這么多的工藝來讓我們選擇,當(dāng)然每一種工藝都各有千秋,存在的既是合理的,關(guān)鍵是我們要認(rèn)識(shí)他們用好他們。

下邊來對(duì)比一下不同的PCB表面處理工藝的優(yōu)缺點(diǎn)和適用場(chǎng)景。
裸銅板

優(yōu)點(diǎn):成本低、表面平整,焊接性良好(在沒有被氧化的情況下)。
缺點(diǎn):容易受到酸及濕度影響,不能久放,拆封后需在2小時(shí)內(nèi)用完,因?yàn)殂~暴露在空氣中容易氧化;無法使用于雙面板,因?yàn)榻?jīng)過第一次回流焊后第二面就已經(jīng)氧化了。如果有測(cè)試點(diǎn),必須加印錫膏以防止氧化,否則后續(xù)將無法與探針接觸良好。
噴錫板(HASL,Hot Air Solder Levelling,熱風(fēng)整平)

優(yōu)點(diǎn):價(jià)格較低,焊接性能佳。
缺點(diǎn):不適合用來焊接細(xì)間隙的引腳以及過小的元器件,因?yàn)閲婂a板的表面平整度較差。在PCB加工中容易產(chǎn)生錫珠(solder bead),對(duì)細(xì)間隙引腳(fine pitch)元器件較易造成短路。使用于雙面SMT工藝時(shí),因?yàn)榈诙嬉呀?jīng)過了一次高溫回流焊,極容易發(fā)生噴錫重新熔融而產(chǎn)生錫珠或類似水珠受重力影響成滴落的球狀錫點(diǎn),造成表面更不平整進(jìn)而影響焊接問題。
噴錫工藝曾經(jīng)在PCB表面處理工藝中處于主導(dǎo)地位。二十世紀(jì)八十年代,超過四分之三的PCB使用噴錫工藝,但過去十年以來業(yè)界一直都在減少噴錫工藝的使用。噴錫工藝制程比較臟、難聞、危險(xiǎn),因而從未是令人喜愛的工藝,但噴錫工藝對(duì)于尺寸較大的元件和間距較大的導(dǎo)線而言,卻是極好的工藝。在密度較高的PCB中,噴錫工藝的平坦性將影響后續(xù)的組裝;故HDI板一般不采用噴錫工藝。隨著技術(shù)的進(jìn)步,業(yè)界現(xiàn)在已經(jīng)出現(xiàn)了適于組裝間距更小的QFP和BGA的噴錫工藝,但實(shí)際應(yīng)用較少。目前一些工廠采用OSP工藝和浸金工藝來代替噴錫工藝;技術(shù)上的發(fā)展也使得一些工廠采用沉錫、沉銀工藝。加上近年來無鉛化的趨勢(shì),噴錫工藝使用受到進(jìn)一步的限制。雖然目前已經(jīng)出現(xiàn)所謂的無鉛噴錫,但這可將涉及到設(shè)備的兼容性問題。
OSP(Organic Soldering Preservative,防氧化)

優(yōu)點(diǎn):具有裸銅板焊接的所有優(yōu)點(diǎn),過期(三個(gè)月)的板子也可以重新做表面處理,但通常以一次為限。
缺點(diǎn):容易受到酸及濕度影響。使用于二次回流焊時(shí),需在一定時(shí)間內(nèi)完成,通常第二次回流焊的效果會(huì)比較差。存放時(shí)間如果超過三個(gè)月就必須重新表面處理。打開包裝后需在24小時(shí)內(nèi)用完。 OSP為絕緣層,所以測(cè)試點(diǎn)必須加印錫膏以去除原來的OSP層才能接觸針點(diǎn)作電性測(cè)試。
OSP工藝可以用在低技術(shù)含量的PCB,也可以用在高技術(shù)含量的PCB上,如單面電視機(jī)用PCB、高密度芯片封裝用板。對(duì)于BGA方面,OSP應(yīng)用也較多。PCB如果沒有表面連接功能性要求或者儲(chǔ)存期的限定,OSP工藝將是最理想的表面處理工藝。但OSP不適合用在少量多樣的產(chǎn)品上面,也不適合用在需求預(yù)估不準(zhǔn)的產(chǎn)品上,如果公司內(nèi)電路板的庫(kù)存經(jīng)常超過六個(gè)月,真的不建議使用OSP表面處理的板子。
沉金(ENIG,Electroless Nickel Immersion Gold)
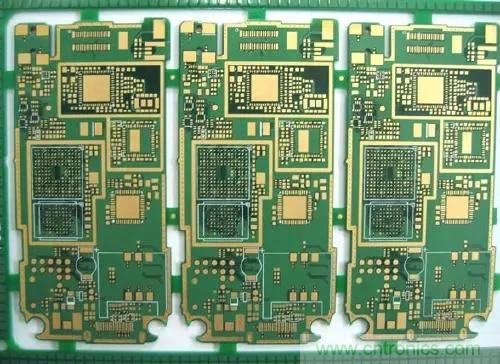
優(yōu)點(diǎn):不易氧化,可長(zhǎng)時(shí)間存放,表面平整,適合用于焊接細(xì)間隙引腳以及焊點(diǎn)較小的元器件。有按鍵PCB板的首選。可以重復(fù)多次過回流焊也不太會(huì)降低其可焊性。可以用來作為COB(Chip On Board)打線的基材。
缺點(diǎn):成本較高,焊接強(qiáng)度較差,因?yàn)槭褂脽o電鍍鎳制程,容易有黑盤的問題產(chǎn)生。鎳層會(huì)隨著時(shí)間氧化,長(zhǎng)期的可靠性是個(gè)問題。
沉金工藝與OSP工藝不同,它主要用在表面有連接功能性要求和較長(zhǎng)的儲(chǔ)存期的板子上,如按鍵觸點(diǎn)區(qū)、路由器殼體的邊緣連接區(qū)和芯片處理器彈性連接的電性接觸區(qū)。由于噴錫工藝的平坦性問題和OSP工藝助焊劑的清除問題,二十世紀(jì)九十年代沉金使用很廣;后來由于黑盤、脆的鎳磷合金的出現(xiàn),沉金工藝的應(yīng)用有所減少,不過目前幾乎每個(gè)高技術(shù)的PCB廠都有沉金線??紤]到除去銅錫金屬間化合物時(shí)焊點(diǎn)會(huì)變脆,相對(duì)脆的鎳錫金屬間化合物處將出現(xiàn)很多的問題。因此,便攜式電子產(chǎn)品(如手機(jī))幾乎都采用OSP、沉銀或沉錫形成的銅錫金屬間化合物焊點(diǎn),而采用沉金形成按鍵區(qū)、接觸區(qū)和EMI的屏蔽區(qū),即所謂的選擇性沉金工藝。
沉銀(ENIG,Electroless Nickel Immersion Gold)

沉銀比沉金便宜,如果PCB有連接功能性要求和需要降低成本,沉銀是一個(gè)好的選擇;加上沉銀良好的平坦度和接觸性,那就更應(yīng)該選擇沉銀工藝。在通信產(chǎn)品、汽車、電腦外設(shè)方面沉銀應(yīng)用得很多,在高速信號(hào)設(shè)計(jì)方面沉銀也有所應(yīng)用。由于沉銀具有其它表面處理所無法匹敵的良好電性能,它也可用在高頻信號(hào)中。EMS推薦使用沉銀工藝是因?yàn)樗子诮M裝和具有較好的可檢查性。但是由于沉銀存在諸如失去光澤、焊點(diǎn)空洞等缺陷使得其增長(zhǎng)緩慢(但沒有下降)。
沉錫(ENIG,Electroless Nickel Immersion Gold)

沉錫被引入表面處理工藝是近十年的事情,該工藝的出現(xiàn)是生產(chǎn)自動(dòng)化的要求的結(jié)果。沉錫在焊接處沒有帶入任何新元素,特別適用于通信用背板。在板子的儲(chǔ)存期之外錫將失去可焊性,因而沉錫需要較好的儲(chǔ)存條件。另外沉錫工藝中由于含有致癌物質(zhì)而被限制使用。
老wu經(jīng)常發(fā)現(xiàn)小伙伴們會(huì)對(duì)沉金和鍍金工藝傻傻搞不清楚,下邊來對(duì)比下沉金工藝和鍍金工藝的區(qū)別和適用場(chǎng)景

沉金與鍍金形成的晶體結(jié)構(gòu)不一樣,沉金板較鍍金板更容易焊接,不會(huì)造成焊接不良;
沉金板只有焊盤上有鎳金,趨膚效應(yīng)中信號(hào)的傳輸是在銅層不會(huì)對(duì)信號(hào)有影響;
沉金較鍍金晶體結(jié)構(gòu)更致密,不易氧化;
沉金板只有焊盤上有鎳金,不會(huì)產(chǎn)生金絲造成微短;
沉金板只有焊盤上有鎳金,線路上阻焊與銅層結(jié)合更牢固;
沉金顯金黃色,較鍍金更黃也更好看;
沉金比鍍金軟,所以在耐磨性上不如鍍金,對(duì)于金手指板則鍍金效果會(huì)更好。
附:PCB術(shù)語及英文對(duì)照
PCB專業(yè)英譯術(shù)語
一、 綜合詞匯
1、 印制電路:printed circuit
2、 印制線路:printed wiring
3、 印制板:printed board
4、 印制板電路:printed circuit board (PCB)
5、 印制線路板:printed wiring board(PWB)
6、 印制組件:printed component
7、 印制接點(diǎn):printed contact
8、 印制板裝配:printed board assembly
9、 板:board
10、 單面印制板:single-sided printed board(SSB)
11、 雙面印制板:double-sided printed board(DSB)
12、 多層印制板:mulitlayer printed board(MLB)
13、 多層印制電路板:mulitlayer printed circuit board
14、 多層印制線路板:mulitlayer prited wiring board
15、 剛性印制板:rigid printed board
16、 剛性單面印制板:rigid single-sided printed borad
17、 剛性雙面印制板:rigid double-sided printed borad
18、 剛性多層印制板:rigid multilayer printed board
19、 撓性多層印制板:flexible multilayer printed board
20、 撓性印制板:flexible printed board
21、 撓性單面印制板:flexible single-sided printed board
22、 撓性雙面印制板:flexible double-sided printed board
23、 撓性印制電路:flexible printed circuit (FPC)
24、 撓性印制線路:flexible printed wiring
25、 剛性印制板:flex-rigid printed board, rigid-flex printed board
26、 剛性雙面印制板:flex-rigid double-sided printed board, rigid-flex double-sided printed
27、 剛性多層印制板:flex-rigid multilayer printed board, rigid-flex multilayer printed board
28、 齊平印制板:flush printed board
29、 金屬芯印制板:metal core printed board
30、 金屬基印制板:metal base printed board
31、 多重布線印制板:mulit-wiring printed board
32、 陶瓷印制板:ceramic substrate printed board
33、 導(dǎo)電膠印制板:electroconductive paste printed board
34、 模塑電路板:molded circuit board
35、 模壓印制板:stamped printed wiring board
36、 順序?qū)訅憾鄬佑≈瓢澹簊equentially-laminated mulitlayer
37、 散線印制板:discrete wiring board
38、 微線印制板:micro wire board
39、 積層印制板:buile-up printed board
40、 積層多層印制板:build-up mulitlayer printed board (BUM)
41、 積層撓印制板:build-up flexible printed board
42、 表面層合電路板:surface laminar circuit (SLC)
43、 埋入凸塊連印制板:B2it printed board
44、 多層膜基板:multi-layered film substrate(MFS)
45、 層間全內(nèi)導(dǎo)通多層印制板:ALIVH multilayer printed board
46、 載芯片板:chip on board (COB)
47、 埋電阻板:buried resistance board
48、 母板:mother board
49、 子板:daughter board
50、 背板:backplane
51、 裸板:bare board
52、 鍵盤板夾心板:copper-invar-copper board
53、 動(dòng)態(tài)撓性板:dynamic flex board
54、 靜態(tài)撓性板:static flex board
55、 可斷拼板:break-away planel
56、 電纜:cable
57、 撓性扁平電纜:flexible flat cable (FFC)
58、 薄膜開關(guān):membrane switch
59、 混合電路:hybrid circuit
60、 厚膜:thick film
61、 厚膜電路:thick film circuit
62、 薄膜:thin film
63、 薄膜混合電路:thin film hybrid circuit
64、 互連:interconnection
65、 導(dǎo)線:conductor trace line
66、 齊平導(dǎo)線:flush conductor
67、 傳輸線:transmission line
68、 跨交:crossover
69、 板邊插頭:edge-board contact
70、 增強(qiáng)板:stiffener
71、 基底:substrate
72、 基板面:real estate
73、 導(dǎo)線面:conductor side
74、 組件面:component side
75、 焊接面:solder side
76、 印制:printing
77、 網(wǎng)格:grid
78、 圖形:pattern
79、 導(dǎo)電圖形:conductive pattern
80、 非導(dǎo)電圖形:non-conductive pattern
81、 字符:legend
82、 標(biāo)志:mark
二、 基材:
1、 基材:base material
2、 層壓板:laminate
3、 覆金屬箔基材:metal-clad bade material
4、 覆銅箔層壓板:copper-clad laminate (CCL)
5、 單面覆銅箔層壓板:single-sided copper-clad laminate
6、 雙面覆銅箔層壓板:double-sided copper-clad laminate
7、 復(fù)合層壓板:composite laminate
8、 薄層壓板:thin laminate
9、 金屬芯覆銅箔層壓板:metal core copper-clad laminate
10、 金屬基覆銅層壓板:metal base copper-clad laminate
11、 撓性覆銅箔絕緣薄膜:flexible copper-clad dielectric film
12、 基體材料:basis material
13、 預(yù)浸材料:prepreg
14、 粘結(jié)片:bonding sheet
15、 預(yù)浸粘結(jié)片:preimpregnated bonding sheer
16、 環(huán)氧玻璃基板:epoxy glass substrate
17、 加成法用層壓板:laminate for additive process
18、 預(yù)制內(nèi)層覆箔板:mass lamination panel
19、 內(nèi)層芯板:core material
20、 催化板材:catalyzed board ,coated catalyzed laminate
21、 涂膠催化層壓板:adhesive-coated catalyzed laminate
22、 涂膠無催層壓板:adhesive-coated uncatalyzed laminate
23、 粘結(jié)層:bonding layer
24、 粘結(jié)膜:film adhesive
25、 涂膠粘劑絕緣薄膜:adhesive coated dielectric film
26、 無支撐膠粘劑膜:unsupported adhesive film
27、 覆蓋層:cover layer (cover lay)
28、 增強(qiáng)板材:stiffener material
29、 銅箔面:copper-clad surface
30、 去銅箔面:foil removal surface
31、 層壓板面:unclad laminate surface
32、 基膜面:base film surface
33、 膠粘劑面:adhesive faec
34、 原始光潔面:plate finish
35、 粗面:matt finish
36、 縱向:length wise direction
37、 模向:cross wise direction
38、 剪切板:cut to size panel
39、 酚醛紙質(zhì)覆銅箔板:phenolic cellulose paper copper-clad laminates(phenolic/paper CCL)
40、 環(huán)氧紙質(zhì)覆銅箔板:epoxide cellulose paper copper-clad laminates (epoxy/paper CCL)
41、 環(huán)氧玻璃布基覆銅箔板:epoxide woven glass fabric copper-clad laminates
42、 環(huán)氧玻璃布紙復(fù)合覆銅箔板:epoxide cellulose paper core, glass cloth surfaces copper-clad laminates
43、 環(huán)氧玻璃布玻璃纖維復(fù)合覆銅箔板:epoxide non woven/woven glass reinforced copper-clad laminates
44、 聚酯玻璃布覆銅箔板:ployester woven glass fabric copper-clad laminates
45、 聚酰亞胺玻璃布覆銅箔板:polyimide woven glass fabric copper-clad laminates
46、 雙馬來酰亞胺三嗪環(huán)氧玻璃布覆銅箔板:bismaleimide/triazine/epoxide woven glass fabric copper-clad lamimates
47、 環(huán)氧合成纖維布覆銅箔板:epoxide synthetic fiber fabric copper-clad laminates
48、 聚四乙烯玻璃纖維覆銅箔板:teflon/fiber glass copper-clad laminates
49、 超薄型層壓板:ultra thin laminate
50、 陶瓷基覆銅箔板:ceramics base copper-clad laminates
51、 紫外線阻擋型覆銅箔板:UV blocking copper-clad laminates
三、 基材的材料
1、 A階樹脂:A-stage resin
2、 B階樹脂:B-stage resin
3、 C階樹脂:C-stage resin
4、 環(huán)氧樹脂:epoxy resin
5、 酚醛樹脂:phenolic resin
6、 聚酯樹脂:polyester resin
7、 聚酰亞胺樹脂:polyimide resin
8、 雙馬來酰亞胺三嗪樹脂:bismaleimide-triazine resin
9、 丙烯酸樹脂:acrylic resin
10、 三聚氰胺甲醛樹脂:melamine formaldehyde resin
11、 多官能環(huán)氧樹脂:polyfunctional epoxy resin
12、 溴化環(huán)氧樹脂:brominated epoxy resin
13、 環(huán)氧酚醛:epoxy novolac
14、 氟樹脂:fluroresin
15、 硅樹脂:silicone resin
16、 硅烷:silane
17、 聚合物:polymer
18、 無定形聚合物:amorphous polymer
19、 結(jié)晶現(xiàn)象:crystalline polamer
20、 雙晶現(xiàn)象:dimorphism
21、 共聚物:copolymer
22、 合成樹脂:synthetic
23、 熱固性樹脂:thermosetting resin
24、 熱塑性樹脂:thermoplastic resin
25、 感旋光性樹脂:photosensitive resin
26、 環(huán)氧當(dāng)量:weight per epoxy equivalent (WPE)
27、 環(huán)氧值:epoxy value
28、 雙氰胺:dicyandiamide
29、 粘結(jié)劑:binder
30、 膠粘劑:adesive
31、 固化劑:curing agent
32、 阻燃劑:flame retardant
33、 遮光劑:opaquer
34、 增塑劑:plasticizers
35、 不飽和聚酯:unsatuiated polyester
36、 聚酯薄膜:polyester
37、 聚酰亞胺薄膜:polyimide film (PI)
38、 聚四氟乙烯:polytetrafluoetylene (PTFE)
39、 聚全氟乙烯丙烯薄膜:perfluorinated ethylene-propylene copolymer film (FEP)
40、 增強(qiáng)材料:reinforcing material
41、 玻璃纖維:glass fiber
42、 E玻璃纖維:E-glass fibre
43、 D玻璃纖維:D-glass fibre
44、 S玻璃纖維:S-glass fibre
45、 玻璃布:glass fabric
46、 非織布:non-woven fabric
47、 玻璃纖維墊:glass mats
48、 紗線:yarn
49、 單絲:filament
50、 絞股:strand
51、 緯紗:weft yarn
52、 經(jīng)紗:warp yarn
53、 但尼爾:denier
54、 經(jīng)向:warp-wise
55、 緯向:weft-wise, filling-wise
56、 織物經(jīng)緯密度:thread count
57、 織物組織:weave structure
58、 平紋組織:plain structure
59、 壞布:grey fabric
60、 稀松織物:woven scrim
61、 弓緯:bow of weave
62、 斷經(jīng):end missing
63、 缺緯:mis-picks
64、 緯斜:bias
65、 折痕:crease
66、 云織:waviness
67、 魚眼:fish eye
68、 毛圈長(zhǎng):feather length
69、 厚薄段:mark
70、 裂縫:split
71、 捻度:twist of yarn
72、 浸潤(rùn)劑含量:size content
73、 浸潤(rùn)劑殘留量:size residue
74、 處理劑含量:finish level
75、 浸潤(rùn)劑:size
76、 偶聯(lián)劑:couplint agent
77、 處理織物:finished fabric
78、 聚酰胺纖維:polyarmide fiber
79、 聚酯纖維非織布:non-woven polyester fabric
80、 浸漬絕緣縱紙:impregnating insulation paper
81、 聚芳酰胺纖維紙:aromatic polyamide paper
82、 斷裂長(zhǎng):breaking length
83、 吸水高度:height of capillary rise
84、 濕強(qiáng)度保留率:wet strength retention
85、 白度:whitenness
86、 陶瓷:ceramics
87、 導(dǎo)電箔:conductive foil
88、 銅箔:copper foil
89、 電解銅箔:electrodeposited copper foil (ED copper foil)
90、 壓延銅箔:rolled copper foil
91、 退火銅箔:annealed copper foil
92、 壓延退火銅箔:rolled annealed copper foil (RA copper foil)
93、 薄銅箔:thin copper foil
94、 涂膠銅箔:adhesive coated foil
95、 涂膠脂銅箔:resin coated copper foil (RCC)
96、 復(fù)合金屬箔:composite metallic material
97、 載體箔:carrier foil
98、 殷瓦:invar
99、 箔(剖面)輪廓:foil profile
100、 光面:shiny side
101、 粗糙面:matte side
102、 處理面:treated side
103、 防銹處理:stain proofing
104、 雙面處理銅箔:double treated foil
四、 設(shè)計(jì)
1、 原理圖:shematic diagram
2、 邏輯圖:logic diagram
3、 印制線路布設(shè):printed wire layout
4、 布設(shè)總圖:master drawing
5、 可制造性設(shè)計(jì):design-for-manufacturability
6、 計(jì)算機(jī)輔助設(shè)計(jì):computer-aided design.(CAD)
7、 計(jì)算機(jī)輔助制造:computer-aided manufacturing.(CAM)
8、 計(jì)算機(jī)集成制造:computer integrat manufacturing.(CIM)
9、 計(jì)算機(jī)輔助工程:computer-aided engineering.(CAE)
10、 計(jì)算機(jī)輔助測(cè)試:computer-aided test.(CAT)
11、 電子設(shè)計(jì)自動(dòng)化:electric design automation .(EDA)
12、 工程設(shè)計(jì)自動(dòng)化:engineering design automaton .(EDA2)
13、 組裝設(shè)計(jì)自動(dòng)化:assembly aided architectural design. (AAAD)
14、 計(jì)算機(jī)輔助制圖:computer aided drawing
15、 計(jì)算機(jī)控制顯示:computer controlled display .(CCD)
16、 布局:placement
17、 布線:routing
18、 布圖設(shè)計(jì):layout
19、 重布:rerouting
20、 模擬:simulation
21、 邏輯模擬:logic simulation
22、 電路模擬:circit simulation
23、 時(shí)序模擬:timing simulation
24、 模塊化:modularization
25、 布線完成率:layout effeciency
26、 機(jī)器描述格式:machine descriptionm format .(MDF)
27、 機(jī)器描述格式數(shù)據(jù)庫(kù):MDF databse
28、 設(shè)計(jì)數(shù)據(jù)庫(kù):design database
29、 設(shè)計(jì)原點(diǎn):design origin
30、 優(yōu)化(設(shè)計(jì)):optimization (design)
31、 供設(shè)計(jì)優(yōu)化坐標(biāo)軸:predominant axis
32、 表格原點(diǎn):table origin
33、 鏡像:mirroring
34、 驅(qū)動(dòng)文件:drive file
35、 中間文件:intermediate file
36、 制造文件:manufacturing documentation
37、 隊(duì)列支撐數(shù)據(jù)庫(kù):queue support database
38、 組件安置:component positioning
39、 圖形顯示:graphics dispaly
40、 比例因子:scaling factor
41、 掃描填充:scan filling
42、 矩形填充:rectangle filling
43、 填充域:region filling
44、 實(shí)體設(shè)計(jì):physical design
45、 邏輯設(shè)計(jì):logic design
46、 邏輯電路:logic circuit
47、 層次設(shè)計(jì):hierarchical design
48、 自頂向下設(shè)計(jì):top-down design
49、 自底向上設(shè)計(jì):bottom-up design
50、 線網(wǎng):net
51、 數(shù)字化:digitzing
52、 設(shè)計(jì)規(guī)則檢查:design rule checking
53、 走(布)線器:router (CAD)
54、 網(wǎng)絡(luò)表:net list
55、 計(jì)算機(jī)輔助電路分析:computer-aided circuit analysis
56、 子線網(wǎng):subnet
57、 目標(biāo)函數(shù):objective function
58、 設(shè)計(jì)后處理:post design processing (PDP)
59、 交互式制圖設(shè)計(jì):interactive drawing design
60、 費(fèi)用矩陣:cost metrix
61、 工程圖:engineering drawing
62、 方塊框圖:block diagram
63、 迷宮:moze
64、 組件密度:component density
65、 巡回售貨員問題:traveling salesman problem
66、 自由度:degrees freedom
67、 入度:out going degree
68、 出度:incoming degree
69、 曼哈頓距離:manhatton distance
70、 歐幾里德距離:euclidean distance
71、 網(wǎng)絡(luò):network
72、 陣列:array
73、 段:segment
74、 邏輯:logic
75、 邏輯設(shè)計(jì)自動(dòng)化:logic design automation
76、 分線:separated time
77、 分層:separated layer
78、 定順序:definite sequenc
五、 形狀與尺寸:
1、 導(dǎo)線(信道):conduction (track)
2、 導(dǎo)線(體)寬度:conductor width
3、 導(dǎo)線距離:conductor spacing
4、 導(dǎo)線層:conductor layer
5、 導(dǎo)線寬度/間距:conductor line/space
6、 第一導(dǎo)線層:conductor layer No.1
7、 圓形盤:round pad
8、 方形盤:square pad
9、 菱形盤:diamond pad
10、 長(zhǎng)方形焊盤:oblong pad
11、 子彈形盤:bullet pad
12、 淚滴盤:teardrop pad
13、 雪人盤:snowman pad
14、 V形盤:V-shaped pad
15、 環(huán)形盤:annular pad
16、 非圓形盤:non-circular pad
17、 隔離盤:isolation pad
18、 非功能連接盤:monfunctional pad
19、 偏置連接盤:offset land
20、 腹(背)裸盤:back-bard land
21、 盤址:anchoring spaur
22、 連接盤圖形:land pattern
23、 連接盤網(wǎng)格陣列:land grid array
24、 孔環(huán):annular ring
25、 組件孔:component hole
26、 安裝孔:mounting hole
27、 支撐孔:supported hole
28、 非支撐孔:unsupported hole
29、 導(dǎo)通孔:via
30、 鍍通孔:plated through hole (PTH)
31、 余隙孔:access hole
32、 盲孔:blind via (hole)
33、 埋孔:buried via hole
34、 埋/盲孔:buried /blind via
35、 任意層內(nèi)部導(dǎo)通孔:any layer inner via hole (ALIVH)
36、 全部鉆孔:all drilled hole
37、 定位孔:toaling hole
38、 無連接盤孔:landless hole
39、 中間孔:interstitial hole
40、 無連接盤導(dǎo)通孔:landless via hole
41、 引導(dǎo)孔:pilot hole
42、 端接全隙孔:terminal clearomee hole
43、 準(zhǔn)表面間鍍覆孔:quasi-interfacing plated-through hole
44、 準(zhǔn)尺寸孔:dimensioned hole
45、 在連接盤中導(dǎo)通孔:via-in-pad
46、 孔位:hole location
47、 孔密度:hole density
48、 孔圖:hole pattern
49、 鉆孔圖:drill drawing
50、 裝配圖:assembly drawing
51、 印制板組裝圖:printed board assembly drawing
52、 參考基準(zhǔn):datum referan
六、流程
1.開料:CutLamination/Material cutting
2.鉆孔:Drilling
3.內(nèi)鉆:Inner LayerDrilling
4一次孔:Outer Layer Drilling
5.二次孔:2nd Drilling
6.雷射鉆孔:Laser Drilling /Laser Ablation
7.盲(埋)孔鉆孔:Blind & Buried Hole Drilling
8.干膜制程:PhotoProcess(D/F)/Dry Film
9.前處理 (Pretreatment)
10.壓膜:Dry Film Lamination
11.曝光:Exposure
12.顯影:Developing
13.去膜:Stripping
14.壓合:Lamination
15:黑化:Black OxideTreatment
16.微蝕:Microetching
17.鉚釘組合:eyelet
18.迭板:Lay up
19.壓合:Lamination
20.后處理:Post Treatment
21.黑氧化:Black Oxide Removal
22.銑靶:spot face
23.去溢膠:resin flush removal
24.減銅:Copper Reduction
25.水平電鍍:HorizontalElectrolytic Plating
26.電鍍:Panel plating
27.錫鉛電鍍:Tin-Lead Plating /Pattern Plating
28.低于 1 mil: Less than 1 mil Thickness
29.高于 1 mil:More than 1 mil Thickness
30.砂帶研磨:Belt Sanding
31:剝錫鉛:Tin-Lead Stripping
32.微切片: Microsection
33.蝕銅:Etching
34.初檢:Touch-up
35.塞孔:Plug Hole
36.防焊(綠漆/綠油):SolderMask
37.C面印刷:Printing Top Side
38.S面印刷:Printing Bottom Side
39.靜電噴涂:Spray Coating
40.前處理:Pretreatment
41.預(yù)烤:Precure
42.后烘烤:Postcure
43.印刷:Ink Print
44.表面刷磨:Scrub
45.后烘烤:Postcure
46.UV烘烤:UV Cure
47.文字印刷:Printing of Legend
48.噴砂:Pumice/Wet Blasting
49.印可剝離防焊/藍(lán)膠:Peelable Solder Mask)
50.化學(xué)前處理,化學(xué)研磨:Chemical Milling
51.選擇性浸金壓膜:Selective Gold Dry Film Lamination
52.鍍金:Gold plating
53.噴錫:Hot Air SolderLeveling
54.成型:Profile/Form
55.開短路測(cè)試:Electrical Testing
56.終檢:Final VisualInspection
57.金手指鍍鎳金:Gold Finger
58.電鍍軟金:Soft Ni/Au Plating
59.浸鎳金:Immersion Ni/Au / Electroless Ni/Au
60.噴錫:Hot Air Solder Leveling
61.水平噴錫:HorizontalHot Air Solder Leveling
62.垂直噴錫: Vertical Hot Air Solder Leveling
63.超級(jí)焊錫:Super Solder
64.印焊錫突點(diǎn):Solder Bump
65.數(shù)控銑/鑼板:N/C Routing/Milling
66.模具沖/啤板:Punch
67.板面清洗烘烤:Cleaning & Backing
68.V型槽/V-CUT: V-Cut/V-Scoring
69.金手指斜邊:Beveling of G/F
70.短斷路測(cè)試Electrical Testing/Continuity & Insulation Testing
71.AOI 光學(xué)檢查:AOI Inspection
72:VRS 目檢:Verified & Repaired
73.泛用型治具測(cè)試:Universal Tester
74.專用治具測(cè)試:Dedicated Tester
75.飛針測(cè)試:Flying Probe
76.終檢:Final Visual Inspection
77.壓板翹:Warpage Remove
78.X-OUT 印刷:X-Out Marking
79.包裝及出貨:Packing& shipping
80.清洗及烘烤: Final Clean & Baking
81.銅面保護(hù)劑:ENTEK Cu-106A/OSP
82.離子殘余量測(cè)試:Ionic Contamination Test/ Cleanliness Test
83.冷熱沖擊試驗(yàn):Thermal cycling Testing
84.焊錫性試驗(yàn):Solderability Testing
85.雷射鉆孔:Laser Ablation
86.雷射鉆Tooling孔:Laser ablationTooling Hole
87.雷射曝光對(duì)位孔:Laser Ablation Registration Hole
88.雷射Mask制作:Laser Mask
89.雷射鉆孔:Laser Ablation
90.AOI檢查及VRS:AOI Inspection & Verified & Repaired
91.除膠渣:Desmear
92.專用治具測(cè)試:Dedicated Tester
93.飛針測(cè)試:Flying Probe
94.壓板翹: Warpage Remove
95.底片:Ablation
96.燒溶:laser)
97.切/磨:abrade
98.粗化:abrasion
99.耐磨性:absorption resistance
100.允收:ACC /accept
101.加速腐蝕:accelerated corrosion test
102加速試驗(yàn):accelerated test
103.速化反應(yīng):acceleration
104.加速劑:accelerator
105.允許:acceptable
106.活化液:activator
107.實(shí)際在制品:active work in process
108.附著力:adhesion
109.黏著法:adhesive method
110.氣泡:air inclusion
111.風(fēng)刀:air knife
112.不定形的改變:amorphous change
113.總量:amount
114.硝基戊烷:amylnitrite
115.分析儀:analyzer
116環(huán)狀墊圈;孔環(huán)annular ring
117.陽極泥:anodeslime (sludge)
118.陽極清洗:anodizing
119.自動(dòng)光學(xué)檢測(cè):AOI/automatic optical inspection
120.引用之文件:applicable documents
121.允收水平抽樣:AQL sampling
122.液態(tài)光阻:aqueous photoresist
123.縱橫比(厚寬比):aspect ratioAs received
124.背光:back lighting
125.墊板:back-up
126.預(yù)留在制品:banked work in process
127.基材:base material
128.基準(zhǔn)績(jī)效:baseline performance
129.批:batch
130.貝他射線照射法:beta backscattering
131.切斜邊;斜邊:beveling
132.二方向之變形:biaxial deformation
133.黑化:black-oxide
134.空板:blank panel
135.挖空:blanking
136.彈開:blip
137.氣泡:blister blistering
138.吹孔:blow hole
139.板厚錯(cuò)誤:board-thickness error
140.黏結(jié)層:bonding plies
141.板彎:bow ; bowing
142.破空:break out
143.搭橋;橋接:bridging
144.接單生產(chǎn):BTO (Build To Order)
145,.燒焦:burning
146.毛邊(毛頭):burr
147.碳化物:carbide
148.定位梢:carlson pin
149.載運(yùn)劑:carrier
150.催化:catalyzing
151.陰極濺射法:catholicsputtering
152.隔板;鋼板:caul plate
153.校驗(yàn)系統(tǒng)之各種要求:calibration system requirements
154.中心光束法:center beam method
155.集中式投射線:central projection
156.認(rèn)證:certification
157.倒角 (金手指):chamfer chamfer
158.切斜邊;倒角:chamfering
159.特性阻抗:characteristic impedance
160.電量傳遞過電壓:charge transfer overpotential
161.網(wǎng)框:chase
162.棋盤:checkboard
163.蟹和劑:chelator
164.化學(xué)鍵:chemical bond
165.化學(xué)蒸著鍍:chemical vapor deposition
166.圓周性之孔破:circumferential void
167.包夾金屬:clad metal
168.無塵室:clean room
169.間隙:clearance
170.表面處理:Coating/Surface Finish
信息整合自吳川斌的微博與網(wǎng)絡(luò)信息
信息整合自吳川斌的微博與網(wǎng)絡(luò)信息




